4,659
社区成员
 发帖
发帖 与我相关
与我相关 我的任务
我的任务 分享
分享在先进节点的芯片制造中,线边粗糙度(LER)成为了一个重要的挑战,特别是在金属线的尺寸越来越小的情况下。LER不仅会影响金属线的形态,还会对线的电阻产生显著影响。本文通过虚拟实验研究,探究了LER对金属线电阻的影响,并提出了相应的分析与结论。
在先进节点,BEOL(后端线路)金属线的RC延迟已成为限制芯片性能的主要因素[1]。较小的金属线间距要求更窄的线宽和线与线之间的距离,这导致更高的金属线电阻和线与线之间的电容。如图1所示,即使没有线边粗糙度(LER),模拟显示随着线宽的缩小,电阻呈指数增长[2]。为了解决这一问题,在较小的节点上需要对金属线的线宽进行优化,并谨慎选择金属材料。
线边粗糙度也是影响电子表面散射和随后线电阻的重要因素。如图1(b)所示,它展示了一个典型的5纳米BEOL M2线的扫描电子显微镜图像,可见LER[3]。最近,我们通过虚拟工艺建模,研究了LER对线电阻的影响,我们改变了RMS振幅、相关长度、使用的材料和金属线宽度。
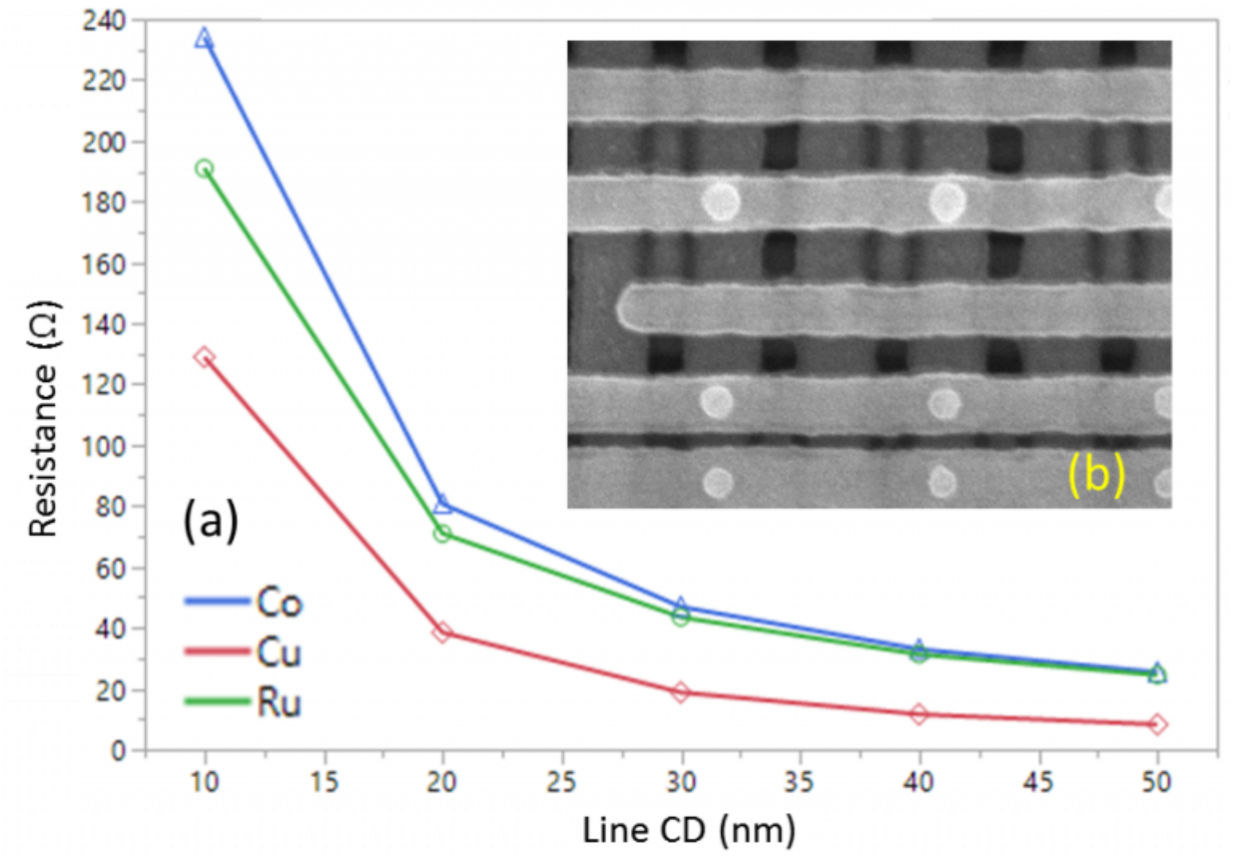
图1:(a) 线电阻与线宽的关系,(b) 5纳米M2的扫描电子显微镜顶视图(由TechInsights提供)。
通过虚拟实验分析
在芯片制造厂中,通过调整线宽和金属线来进行LER变化实验是困难、昂贵且耗时的。在硅晶圆上,由于光刻和蚀刻过程的变异性和限制,对LER的控制也很困难。在这种情况下,可以借由通过软件模拟实际LER金属线结构的方式,计算一系列变量下的电阻率,为研究此类问题提供数据基础。
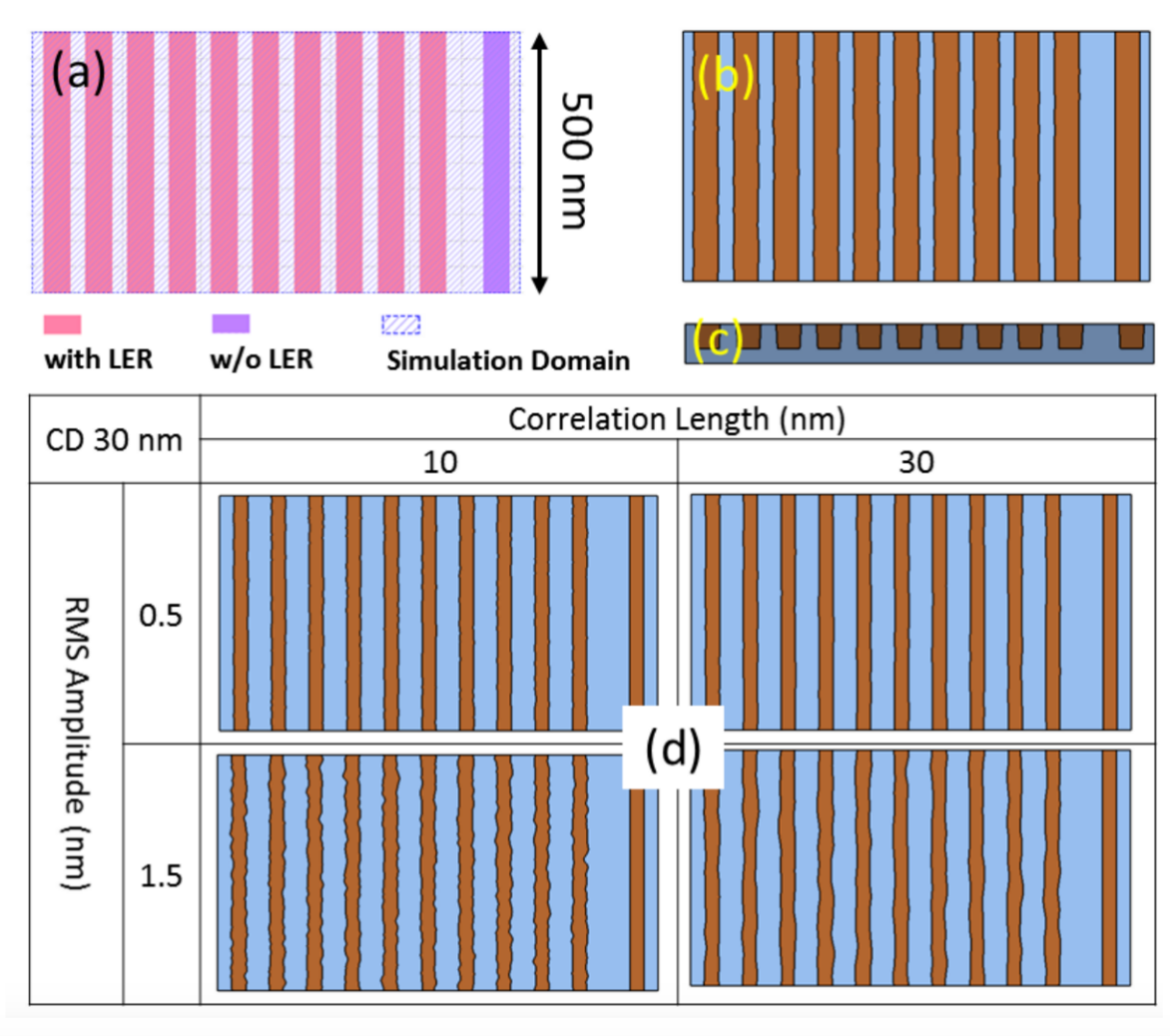
图2(a)展示了使用虚拟工艺建模平台(SEMulator3D®)模拟LER的布局设计。图2(b)和2(c)展示了生成的虚拟制造结构及其模拟的LER,分别从顶视图和横截面视图显示。LER可以直接在虚拟制造的光刻步骤中通过设置特定的RMS振幅(噪声振幅)和相关长度(噪声频率)值来修改。图2(d)展示了不同LER条件下的简单分割实验。线边粗糙度随着不同金属线宽度、RMS振幅和相关长度的变化而变化。为了系统地研究使用不同线宽和材料对线边粗糙度的影响,使用了表1中显示的分割条件完成了实验分割。然后从模拟结果中提取相应的金属线电阻。为了简化,模拟这些结构时未考虑衬底材料。

DOE分割条件。
DOE结果与分析
通过使用表1中的分割条件完成了超过1000次的虚拟DOE实验,以了解LER对金属线电阻的影响。在这些实验中,可以发现:
- 当相关长度较小时且存在高频噪声时,电阻受到LER的强烈影响。
- 在较小的线宽下,电阻受LER RMS振幅和相关长度的影响。
- 在所有线宽和LER条件下,应选择特定的金属材料以获得最低的绝对电阻值。
结论
在先进节点,LER的控制将变得越来越重要,因为LER在较小的金属线宽度下对电阻产生了很大影响。实验通过在过程建模分割实验中改变金属线宽度和金属线材料来研究LER对金属线电阻的影响。
在EUV光刻过程中,由于大多数EUV工具的高测试成本和低能量密度,CDU和LER可能会成为问题。在这种情况下,可能需要修改光刻工艺的开发,以最小化LER。这些修改可以通过虚拟测试来降低开发成本。新的EUV光刻胶方法(例如Lam Research®提出的干式光刻胶)也可能有助于降低较低EUV曝光能量下的线边粗糙度。
在先进节点,为了减少由电子表面散射引起的LER和线电阻,将需要正确选择金属线材料、进行CD优化以及开发新的光刻胶。未来节点可能还需要进一步改进LER(光刻后),以减少LER引起的电阻。
参考资料:
·Chen, H. C., Fan, S. C., Lin, J. H., Cheng, Y. L., Jeng, S. P., & Wu, C. M. (2004). The impact of scaling on metal thickness for advanced back end of line interconnects. Thin solid films, 469, 487-490.
·van der Veen, M. H., Heyler, N., Pedreira, O. V., Ciofi, I., Decoster, S., Gonzalez, V. V., … & Tőkei, Z. (2018, June). Damascene benchmark of Ru, Co and Cu in scaled dimensions. In 2018 IEEE International Interconnect Technology Conference (IITC) (pp. 172-174). IEEE.
·Techinsights TSMC 5nm logic tear down report.
·SEMulator3D - Lam Research